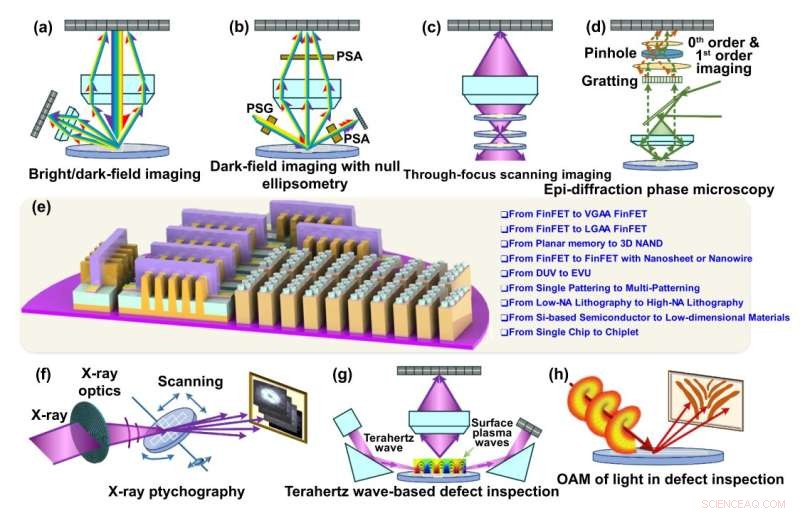
Diversi sistemi ottici di ispezione dei difetti dei wafer tra cui (a) sistema di imaging in campo chiaro/darkfield, (b) imaging in campo scuro con ellissometria nulla, (c) microscopia di imaging a scansione a fuoco passante, (d) microscopia in fase di epi-diffrazione, (e) Patterned wafer contenenti die logiche e die di memoria NAND 3D, (f) ptychography a raggi X, (g) sistema di ispezione dei difetti basato su onde THz e (h) tecniche di scatterometria di Fourier coerenti che utilizzano diversi fasci di illuminazione OAM. Credito:di Jinlong Zhu et al.
Gli scienziati dell'ispezione dei difetti dell'Università di scienza e tecnologia di Huazhong, dell'Harbin Institute of Technology e dell'Università cinese di Hong Kong effettuano un'analisi approfondita di nuove prospettive e tendenze entusiasmanti sulla base di precedenti grandi revisioni nel campo dei metodi di ispezione dei difetti. La revisione si concentra su tre aree specifiche:(1) la valutazione della rilevabilità dei difetti, (2) i diversi sistemi di ispezione ottica e (3) gli algoritmi di post-elaborazione.
Pubblicazione sulla rivista International Journal of Extreme Manufacturing , il Nanoscale and Optical Metrology Research Center (NOMRC) guidato dal Prof. Shiyuan Liu e dal Prof. Jinlong Zhu dell'Università di Scienza e Tecnologia di Huazhong e dai loro collaboratori dell'Harbin Institute of Technology e dell'Università cinese di Hong Kong hanno scritto la prima revisione sistematica per introdurre il background della ricerca, discutere gli ultimi progressi e la tendenza dell'ispezione dei difetti dei wafer ottici. Questa recensione ha rivelato che tecniche all'avanguardia come la nanofotonica, i vortici ottici, l'imaging computazionale, l'imaging di fase quantitativo e l'apprendimento profondo possono avere un profondo impatto sull'ispezione dei difetti al di sotto dei 10 nm. Il lavoro potrebbe aprire nuove strade nel campo dell'ispezione dei difetti dei wafer di semiconduttori.
Il Prof. Jinlong Zhu e il Prof. Shiyuan Liu affermano che "le caratteristiche e lo spazio sempre ridotti sui wafer modellati metterebbero a dura prova le capacità di tutte le attuali soluzioni di metrologia e ispezione nel bilanciare sensibilità, specificità, velocità di processo e velocità di cattura". /P>
L'ispezione ottica dei wafer a campo lontano rimane uno dei cavalli di battaglia per l'ispezione dei difetti nella fabbrica. In uno strumento di ispezione dei difetti convenzionale, i difetti vengono acquisiti confrontando le immagini del modello di circuito di stampi adiacenti. Il primo autore dell'articolo di revisione, il Prof. Jinlong Zhu, afferma che "la chiave per l'ispezione dei difetti non è la risoluzione, ma il rapporto segnale-rumore (SNR) e il contrasto. Il miglioramento dell'SNR e del contrasto dipende fortemente da strumenti sofisticati, architetture di modellazione avanzate e algoritmi di post-elaborazione, che ci hanno spinto a fare una revisione completa dei metodi di rilevamento dei difetti dei wafer dai seguenti tre aspetti:(1) la valutazione della rilevabilità dei difetti, (2) i diversi sistemi di ispezione ottica e (3) ) gli algoritmi di post-elaborazione."
"È di grande importanza eseguire una valutazione della rilevabilità dei difetti per un tipo specifico di strumenti di ispezione per i nodi avanzati", ha spiegato il co-primo autore, il dottor Jiamin Liu. "Infatti, la valutazione della rilevabilità del difetto comporta solitamente la formulazione di regole quantitative per l'SNR dei segnali di diffusione del difetto, lo sviluppo di strumenti di simulazione per la modellazione dei segnali di diffusione del difetto e l'analisi dell'SNR del difetto. Abbiamo scoperto che l'SNR del difetto dipende in modo significativo sulla topologia del materiale e del difetto."
Gli approcci convenzionali nell'ispezione dei difetti ottici, come quello basato sull'ampiezza insieme ai suoi algoritmi di post-elaborazione, sono stati ampiamente discussi. I nuovi meccanismi di ispezione, inclusi quelli basati sui modi di fase, momento angolare orbitale, onde terahertz e iperbolici Bloch, sono stati evidenziati per ricordare ai lettori le loro potenzialità nell'aprire nuove direzioni nel campo. Inoltre, la psichografia a raggi X, l'unico metodo ottico in grado di visualizzare direttamente difetti inferiori a 20 nm sia sulla superficie che sotto la superficie per l'intero wafer, è stata anche esaminata e analizzata in dettaglio nell'articolo. La psichografia a raggi X ha il potenziale per penetrare nel campo fornendo una risoluzione e una sensibilità 3D rivoluzionarie una volta che gli inconvenienti, tra cui la sorgente di luce a raggi X di sincrotrone, un'enorme quantità di dati e la bassa velocità verranno conquistati in futuro.
"Che si tratti del più semplice operatore di differenza dell'immagine o del complesso algoritmo sintetico dell'immagine o persino degli algoritmi di deep learning, questi algoritmi di post-elaborazione svolgono un ruolo fondamentale nell'ispezione dei difetti ottici in termini di miglioramento dell'SNR e del contrasto dei difetti. Pertanto, abbiamo fornito un discussione dettagliata degli algoritmi di post-elaborazione coinvolti nell'ispezione dei difetti dei wafer modellati con un focus specifico sui vantaggi e gli svantaggi degli algoritmi di apprendimento profondo", ha aggiunto ulteriormente il co-primo autore, il dottor Tianlai Xu.
Il professor Jinlong Zhu afferma che "credono che l'ispezione dei difetti ottici sui wafer modellati rimarrà un argomento stimolante ma interessante che deve essere affrontato con urgenza. Riteniamo che questo articolo di revisione, che è stato scritto sulla base di recensioni precedenti e alcune ricerche esplorative nella direzione dell'avanguardia, è importante sia per i nuovi arrivati nel campo che per coloro che stanno cercando di utilizzarlo nel lavoro interdisciplinare". + Esplora ulteriormente