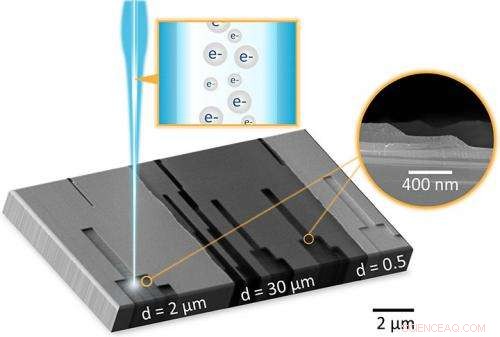
Micrografia elettronica a scansione (SEM) che mostra una vista dall'alto insieme a un SEM (inserto) che mostra una vista in sezione trasversale di strutture in scala di grigi fabbricate utilizzando una combinazione di litografia a fascio elettronico, fotolitografia, e resistere alla verniciatura a spruzzo. Lo schema sovrapposto illustra la scrittura diretta e-beam di scale verticali su nanoscala (inserto SEM) su un substrato con topografia in scala di grigi su microscala. I modelli iniziali in scala di grigi sono stati generati su un laserwriter. Dopo l'incisione del fascio di ioni reattivi, i modelli sono stati scritti simultaneamente in 2 µm, 0,5 micron, e caratteristiche profonde 30 µm.
Gli ingegneri del NIST Center for Nanoscale Science and Technology (CNST) hanno sviluppato una nuova tecnica per fabbricare nanostrutture tridimensionali (3D) ad alto rapporto di aspetto su grandi aree di dispositivi utilizzando una combinazione di litografia a fascio di elettroni (e-beam), fotolitografia, e resistere alla verniciatura a spruzzo. Sebbene sia stato a lungo possibile realizzare complesse strutture 3D con molti livelli di maschera o costose maschere in scala di grigi, la nuova tecnica consente ai ricercatori di incidere trincee e altre strutture ad alto rapporto di aspetto con caratteristiche su scala nanometrica senza l'uso di maschere e in sole due fasi del processo.
La fabbricazione di semiconduttori 3D e strutture dielettriche modellate esponendo resist con gradienti di scala di grigi di intensità variabile è stata essenziale per un'ampia gamma di applicazioni come lenti digitali, sistemi microelettromeccanici, e dispositivi medici fluidici.
A differenza dei dispositivi che si basano su maschere convenzionali, che hanno aree che semplicemente trasmettono o bloccano la luce per formare un motivo, la fabbricazione di questi dispositivi si è basata tipicamente su maschere 3D in scala di grigi che hanno diversi livelli di trasparenza e dipendono dall'uso di materiali proprietari. Poiché la chimica è proprietaria e poiché le maschere sono preparate utilizzando processi complicati più adatti a piccole aree, sono spesso proibitivi. La prossima generazione di questi dispositivi richiede costi inferiori, superfici maggiori, e dimensioni delle caratteristiche sempre più piccole.
Il nuovo approccio dei ricercatori sfrutta l'elevata capacità di rendimento della fotolitografia per generare strutture in scala di grigi di grandi aree con un'ampia flessibilità di elaborazione e la capacità della litografia a fascio elettronico di aggiungere caratteristiche in scala di grigi inferiori a 200 nm. La prima fase di questo approccio mix-and-match consiste nel modellare uno strato di fotoresist esponendolo con un raggio laser focalizzato. Modulando localmente l'intensità della luce per formare un gradiente in scala di grigi, vengono generati diversi livelli di fotoreazione nel fotoresist. Dopo che il campione è stato immerso nella soluzione di sviluppo, il materiale si dissolve in aree corrispondenti al grado di fotoreazione indotta, lasciando lo strato di fotoresist con spessori variabili che corrispondono al modello di esposizione iniziale. Il campione viene esposto a un attacco di ioni reattivi profondi (DRIE) che rimuove il materiale del substrato a profondità variabili che dipendono dallo spessore del fotoresist, trasferendo verticalmente il modello di fotoresist 3D nel substrato per formare microstrutture profonde in scala di grigi. La seconda fase applica passaggi di elaborazione simili ma con dimensioni delle caratteristiche dieci volte inferiori. Primo, viene applicato un rivestimento spray resist e-beam ad alta pressione per ottenere una copertura conforme della topografia ad alto rapporto d'aspetto prodotta nella prima fase. Quindi, manipolando un raggio elettronico ad alta energia con risoluzione su scala nanometrica, le altezze dei gradini in scala di grigi modellate sono scritte direttamente nell'e-beam resist in posizioni diverse. Finalmente, il resist viene sviluppato e il campione viene esposto a DRIE come era nella prima fase.
Il processo in due fasi si traduce in una dimensione delle caratteristiche verticali di 45 ± 6 nm all'interno di una struttura del substrato che varia da 2 μm a 30 μm di profondità e con dimensioni delle caratteristiche orizzontali da 100 nm a 200 nm e una dimensione complessiva del modello potenzialmente grande quanto un intero wafer. Liya Yu, ingegnere di processo NanoFab del CNST, prevede che la capacità di fabbricare nanostrutture in scala di grigi ad alto rapporto di aspetto amplierà le applicazioni pratiche della litografia in scala di grigi e amplierà notevolmente la gamma di strutture di dispositivi disponibili per i progettisti di dispositivi.