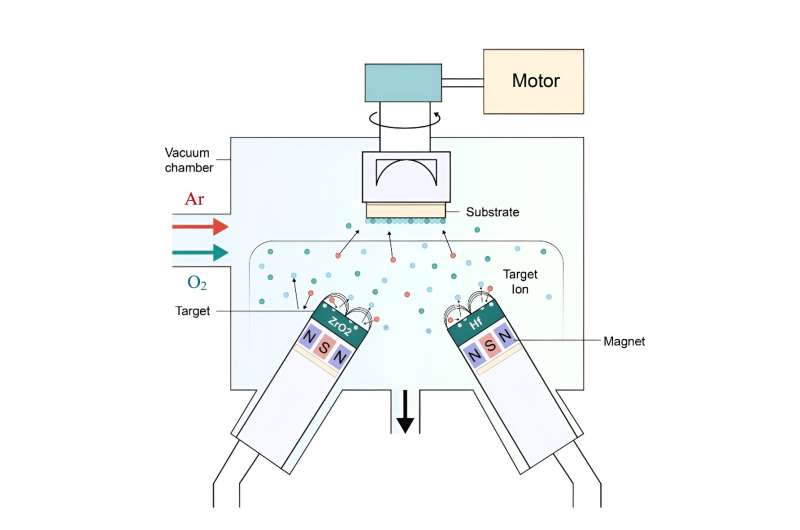
I materiali ferroelettrici a base di ossido di afnio sono candidati promettenti per i dispositivi su scala nanometrica di prossima generazione grazie alla loro integrazione nell'elettronica del silicio.
In uno studio pubblicato su Science , ricercatori dell'Istituto di Microelettronica dell'Accademia Cinese delle Scienze (IMECAS) e dell'Istituto di Fisica del CAS hanno scoperto un ferroelettrico romboedrico stabile Hf(Zr)+x O2 che presenta un campo coercitivo estremamente basso.
L'alto campo coercitivo intrinseco della fluorite ferroelettrica Hf(Zr)O2 i dispositivi portano alla tensione operativa incompatibile con nodi tecnologici avanzati e durata limitata. In questo lavoro, una fase r ferroelettrica stabile Hf(Zr)1+x O2 materiale che riduce efficacemente la barriera di commutazione dei dipoli ferroelettrici in HfO2 sono stati scoperti materiali a base di carbonio.
La microscopia elettronica a trasmissione a scansione (STEM) ha verificato l'intercalazione di atomi di Hf(Zr) in eccesso all'interno dei siti cavi, formando una matrice ordinata. I calcoli della teoria del funzionale della densità (DFT) hanno fornito informazioni sul meccanismo sottostante secondo cui gli atomi intercalati stabilizzano la fase ferroelettrica e riducono la sua barriera di commutazione.
I dispositivi ferroelettrici basati sulla fase r Hf(Zr)1+x O2 mostrano un campo coercitivo ultrabasso (~0,65 MV/cm), un valore elevato di polarizzazione residua (Pr) di 22 μC/cm 2 , un campo di polarizzazione a saturazione ridotta (1,25 MV/cm) e un'elevata resistenza (10 12 cicli).
Il lavoro ha applicazioni nei chip di memoria a basso costo e di lunga durata.
Ulteriori informazioni: Yuan Wang et al, Una fase romboedrica stabile in un condensatore ferroelettrico Hf(Zr) 1+ x O 2 con campo coercitivo ultrabasso, Scienza (2023). DOI:10.1126/science.adf6137
Informazioni sul giornale: Scienza
Fornito dall'Accademia cinese delle scienze